Depósito assistido por plasma
O depósito de capas através de PECVD permite obter películas finas de uma grande variedade de materiais que se depositam sobre um substrato.
![]() Para realizar o processo através de PECVD, é fornecida energia eléctrica a uma mistura de gases em condições de vácuo baixo para gerar o plasma. Os componentes deste plasma podem reagir sobre o substrato.
Para realizar o processo através de PECVD, é fornecida energia eléctrica a uma mistura de gases em condições de vácuo baixo para gerar o plasma. Os componentes deste plasma podem reagir sobre o substrato.
O resultado desta reacção permite o depósito de uma capa superficial com grande uniformidade e qualidade sobre o substrato. Estes processos de depósito são utilizados para depositar materiais (sílica, carbono, nano-tubos de carbono, nitrato de sílica, nitrato de titânio, etc.) em várias formas, mono-cristalina, poli-cristalina, amorfa e epitaxial.
Produtos de esta categoria

ICP Plasma deposition system SI 500 D
Excepcional desempenho para processos de depósitos baseados em plasma. As películas dieléctricas se são de alta qualidade podem ser depositadas por PECVD de alta densidade gerada pela fonte de plasma PTSA ICP.

PECVD loadlock system SI 500 PPD
Fornece uma variedade de processos de deposição de plasma standard. SiO2, SiNx, SiOxNy e a-Si podem ser depositados com o plasma por acoplamento capacitivo.
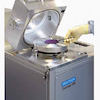
PECVD direct loading system Depolab 200
Combina a carga directa mais eficaz com a fonte de plasma de placas paralelas num design básico e compacto. O sistema inteligente PECVD pode ser actualizado a pedido para melhorar o seu desempenho.